FC300

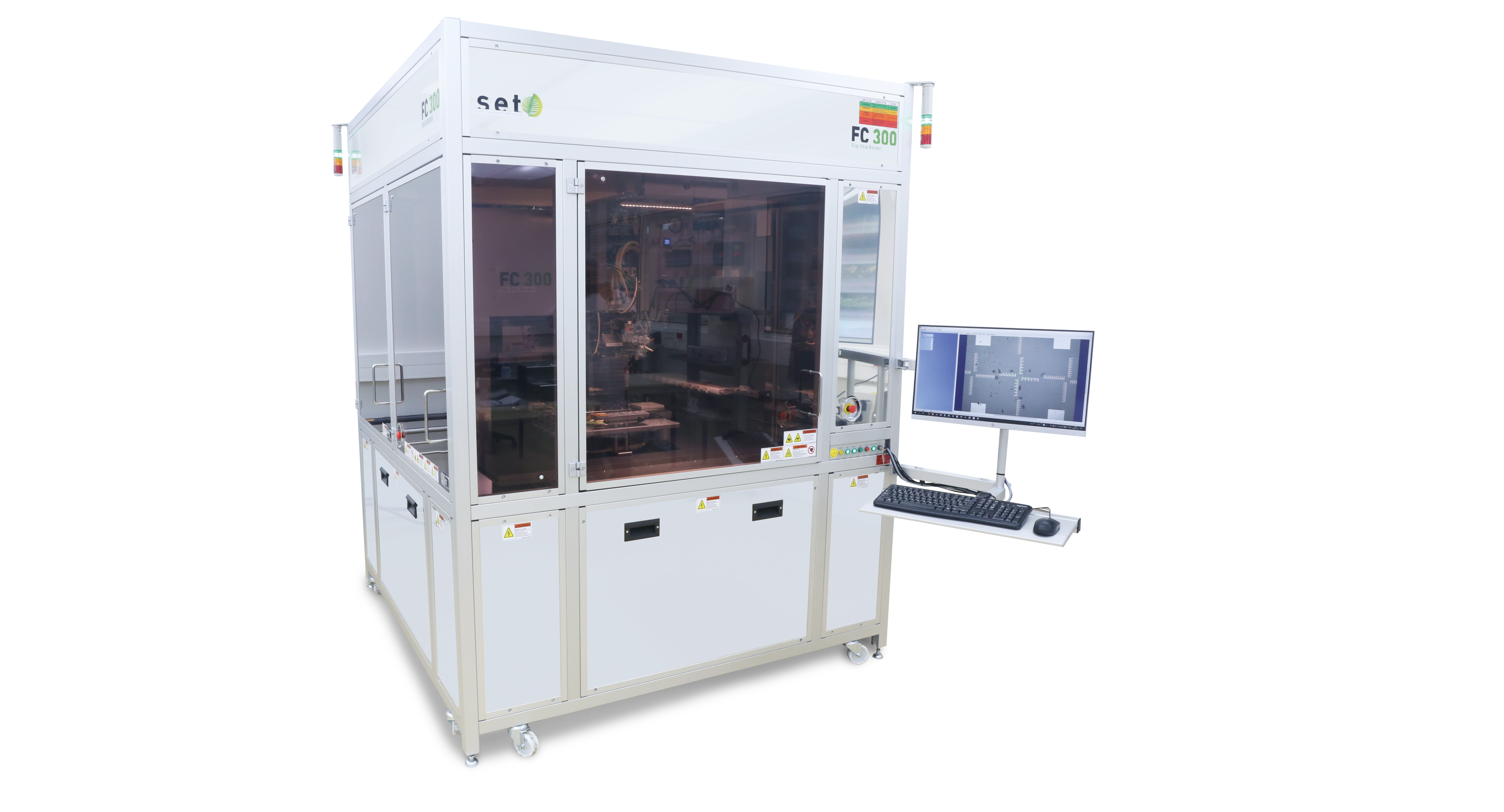
Der FC300 hochgenauer Die- / Flip-Chip Bonder ist die neueste Generation der hochgenauen Systeme mit hoher Kraft für Chip-zu-Chip und Chip-zu-Wafer-Bonden, auf Wafern bis zu 300 mm. Die Maschine bietet einen automatisierten Umgang mit Chips und Substraten bis zu 100 mm aus Wafer Tray, plus eine Roboter-Option, die das Aufnehmen des Chips vom gesägten Wafer und automatisierte Handhabung von größeren Substraten ermöglicht. Der FC300 bietet des Weiteren zusätzliche Funktionen der Nano-Imprint-Lithographie (NIL).
Durch eine schnelle Umrüstung des Bondkopfes bedient die FC300-Plattform verschiedene Anwendungen wie z.B.:
- Hohe Kraft, besonders für Cu-Cu-Bonden interessant, weil in IC 3D-Verpackung verwendet ist, oder Nano-Prägung, die mit einem Heißprägung-Lithographie-Prozess verwendet ist;
- Reflow-Bonden mit geringer Kraft für Montage der Bildgeräte, RF oder Optoelektronik;
- UV-Härtung für adhäsives Bonden oder für Nano-Prägung unter Verwendung eines UV-NIL-Prozesses.
Die wichtigsten Vorteile
- ± 0,5 µm der Genauigkeit nach dem Bonden und 20 µRadiant Nivellierung gewährleisten höchste Qualität für die modernsten Produkte
- Halboffene Prozess-Kammer für Oxid-Verringerung (Option)
- Bonden von Chips bis zu 100 x 100 mm auf Wafer bis zu 300 mm, um Großformat-Montage zu ermöglichen
- NIL-Konfiguration als Zusatz zur Bondfunktion für maximale Flexibilität
- Luftlager-Aufbau auf einer Granitstruktur sorgt für langfristige Stabilität und Zuverlässigkeit
- Optionale integrierte Kammer für Reflow-Gruppe in einem Gas- oder Vakuum-Umfeld
Prozessfähigkeiten
- Die-Bonden (mit der Bildseite nach oben)
- Flip-Chip Bonden (Bildseite zu Bildseite)
- Massen-Reflow, In Situ Reflow, flussmittelfreie, eutektische, Bonden
- Thermokompression-Bonden, Ultraschall-Bonden
- UV-Härtung Bonden, adhäsives Bonden
- UV-NIL, Heißprägung-Lithographie
Anwendungen
- Chip-zu-Chip, Chip-zu-Wafer Bonden
- 3D-Zusammenschaltung, Chip-Aufstapelung, Unterschiedliche Integration
- Montage von Opto-Elektronischen und Photonischen Geräten
- MOEMS, MEMS, MCM
- Nano-Prägung Anwendungen: Optik, Mikro-Strömungstechnik, usw...
