Interconnexion 3D

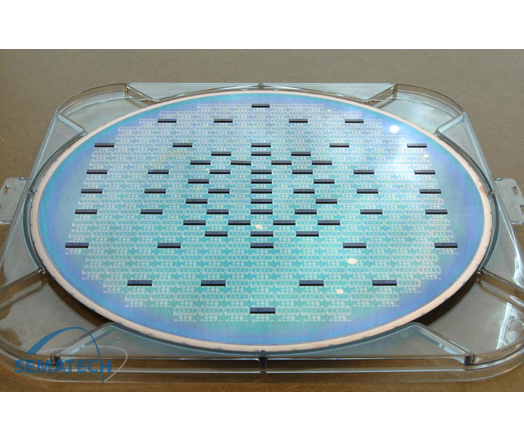
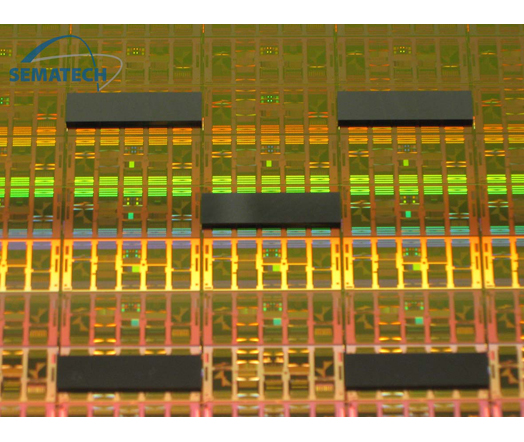
Raccourcir les longueurs de connexion pour diminuer la résistance électrique, améliorer le temps de réponse ainsi que réduire la consommation d’énergie et les dimensions globales est un des principaux objectifs de l’intégration 3D.
Celle-ci permet l’assemblage de composants hétérogènes à haut rendement. Il existe de nombreuses solutions d’assemblage 3D comme :
- Interposeur
- Collage puce à puce direct
- Interconnexion puce sur wafer
Le besoin en précision de placement dépend de l’application et de la méthode utilisée pour obtenir le signal en sortie du composant. L’industrie aujourd’hui se focalise sur les connexions par TSV (Via à Travers le Silicium) entre les couches de puces. L’optimisation du diamètre des TSV et de leur pas demande des précisions de placement encore plus grandes, non seulement selon X et Y, mais aussi en parallélisme entre puces.
Procédé d’assemblage
Une précision après-assemblage élevée et un bon parallélisme entre couches sont des paramètres cruciaux pour l’empilage 3D. Plusieurs procédés sont davantage dédiés à l’intégration 3D comme :
- Refusion locale
- Thermocompression
- Assemblage par collage
- Collage métallique direct
- Etc…
