Assemblage de MEMS
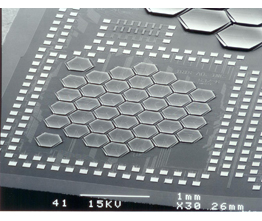

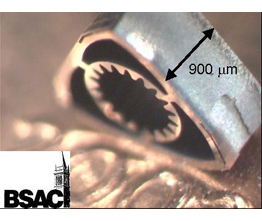
Aujourd’hui, toutes les techniques de fabrication de semi-conducteur imposent des restrictions dans les matériaux, dimensions et les paramètres de procédés. Ceci génère des frontières de conception strictes, quelque peu contradictoires avec la nature interdisciplinaire inhérente aux composants MEMS.
La capacité d’intégrer des éléments mécaniques avec une électronique à une échelle micronique a renforcé les micro-systèmes électromécaniques (MEMS) en tant que technologie d’avenir, se répandant dans une impressionnante variété d’applications. La fabrication de MEMS 3D a certainement bénéficié des mêmes équipements et procédés standards utilisés dans l’industrie du semi-conducteur.
Procédé d’assemblage
Pour contourner ces limitations, des sous-composants peuvent être construits indépendamment en utilisant un mixe de procédés traditionnels et de nouvelles technologies.
Les pièces peuvent alors être assemblées ou hybridées pour faire un composant plus sophistiqué. Ce schéma présente cependant plusieurs défis pour la manipulation, l’alignement et la fixation de chaque composant.
Le Flip-Chip Bonder automatique FC150 de SET a démontré ses capacités de manipuler des pièces délicates (jusqu’à 200 µm) en utilisant des chucks à vide et à les aligner mieux que ± 1 µm.
Des MEMS tels que des systèmes d’optique adaptative ou des têtes d’impression à jet d’encre ont été assemblées sur des Flip-Chips Bonders de SET.
