金属直接键合
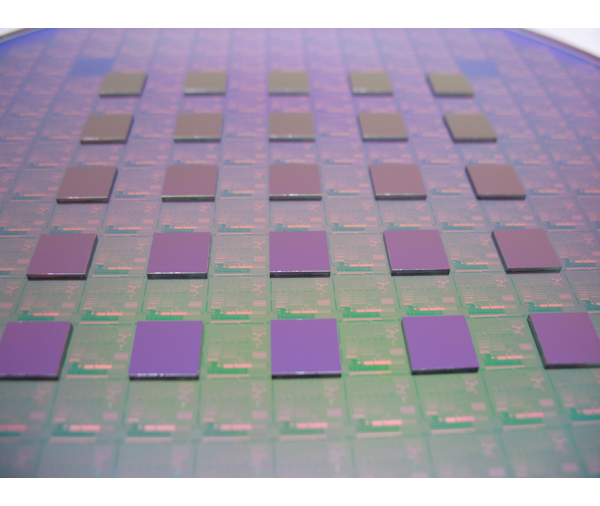
金属直接键合工艺被广泛用于两个不同元器件之间的结合。
尽管工艺难度很高—元器件的表面必须非常洁净,但金属直接键合仍然拥有诸多优点。
三个主要的优势包括:只需较低的键合压力,可以在常温下实现键合,并且工艺时间很短。
从而,金属直接键合工艺可以实现很高的键合精度,特别是在不同热膨胀系数的材料之间,可以避免加热过程带来的精度损失。
这些优势使得金属直接键合成为3D集成技术中从芯片到晶圆键合工艺的绝好实现方式。
PROCEED项目:
2009年,由Minalogic发起,由法国政府(FUI)资助。
目标:证明金属直接键合工艺可以在芯片-晶圆键合工艺中实现(<1 µm)的高精度。
与CEA-LETI,ST-Microelectronics, ALES和 CEMES-CNR等机构一起,SET在一台特殊设计的FC300机型上,成功证明了金属直接键合工艺的可行性。这一成功被很多文章所提及。
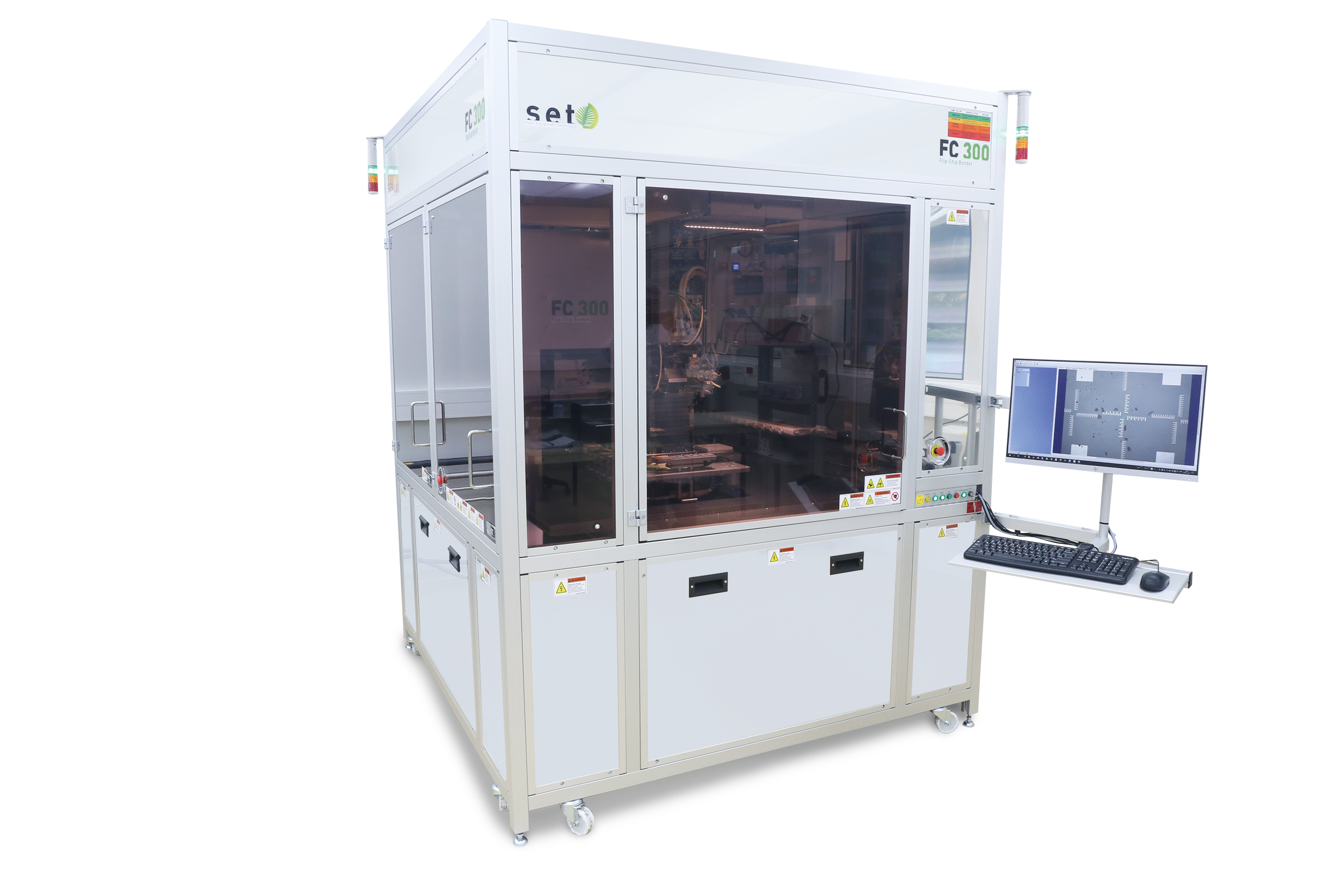
IRT Nanoelec项目:
2015年底:SET参与IRT Nanoelec项目,并为此专门设计一款高速、高精度的设备,专用于金属直接键合工艺。
利用PROCEED项目的经验,SET设计并开发了全新的NEO HB设备,专门用于金属直接键合工艺的生产。
2019年9月:SET在台湾SEMICON展会期间正式推出了NEO HB设备,从而满足3D集成工艺对高产能的迫切需求。
PROCEED项目
PROCEED Minalogic项目为期24个月,耗资420万欧元,由法国FIU(Fond Interministeriel Unique)提供资助。PROCEED项目始于2009年,旨在展示直接金属接合所制成的芯片对晶圆结构的高对准精度(小于1微米)。此类结构对于高性能3D互连电路而言是必不可少的,并且能够在微电子以及光电子或MEMS当中进行广泛应用。
铜对铜直接接合需要良好的平面性以及极高的表面质量,特别是在颗粒和金属污染方面。铜柱和接合点的低粗糙度,以及铜和氧化物区域之间的表面状态,对于在低粘力和室温下获得良好的接合强度来说十分关键。
CEA-Leti开发出这种基于芯片对晶圆的直接金属接合的工艺,来克服3D集成中的某些限制。该技术包括了在低温和低粘力条件下将芯片连接到基板上,以及通过局部金属接合来实现高机械和电气完整性的接合。
ALES提供技术来支持表面处理,而CEMES-CNRS则负责确定接合质量并对退火阶段中铜冶金的变化进行分析。意法半导体公司正在推动该技术在高密度3D集成中的应用。
技术优点
与传统的热压接合相比,这种直接的金属对金属接合技术具有许多优点。
在低压力和室温条件下进行接合,通过避免不同材料的热膨胀,实现了高密度互连的更高精度的接合。为了确保无空隙接合,对准和接合的步骤必须要在无颗粒环境中进行。这要通过使用特殊材料以及对粘合环境的细致管理来实现,从而在晶圆充满颗粒物的时候对其表面进行保护。
对于3D互连集成广泛应用所需的高产量而言,低粘力接合工艺至关重要。
技术论文
|
|
|
|
|
Chip-to-Wafer Technologies for High Density 3D Integration |
May 2011 |
CEA Leti Minatec, ALES, STMicroelectronics, CNRS-CEMES, SET |
