3D Zusammenschaltung

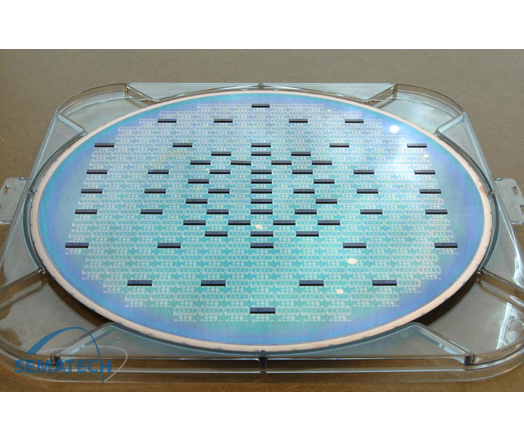
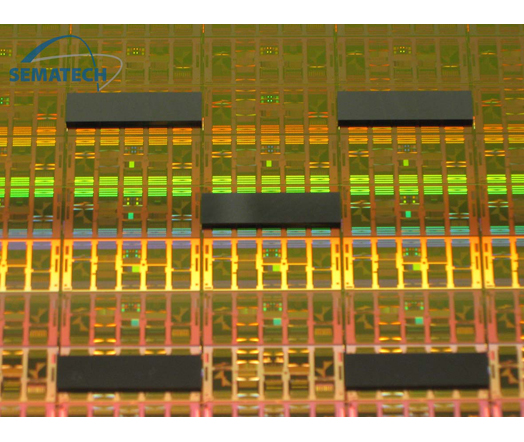
Kürzere Verbindungen, um elektrischen Widerstand zu vermindern, Reaktionszeiten zu verbessern, sowie Stromverbrauch und Gesamtabmessungen zu reduzieren, ist eines der Hauptziele der 3D-Integration.
3D-IC-Integration ermöglicht die Hochleistungsmontage von unterschiedlichen Systemen. Es gibt zahlreiche 3D-Verpackungslösungen, wie:
- Interposer,
- direktes Bonden Chip-zu-Chip oder Die zu-Die,
- Zusammenschaltung Chip-zu-Wafer.
Die Anforderung zur Genauigkeit der Platzierung variiert mit der Anwendung und der verwendeten Methode, um das Signal aus jedem Die zu bekommen. In der Zusammenschaltung Through-Silicon-Via (TSV) - Durchkontaktierung zwischen Chip- Lagen, liegt der Schwerpunkt der modernen Industrie. Die Optimierung des Durchmessers und der Teilung des TSV treibt die Forderungen nach höherer Platziergenauigkeit nicht nur entlang der X- und Y- Achsen, sondern auch nach der Parallelität zwischen den Chips an.
Bonden-Prozess
Hohe Genauigkeit nach dem Bonden und gute Parallelität zwischen jeder Schicht sind entscheidende Parameter für 3D-Aufstapeln. Mehrere Bonden-Prozesse, die mehr für 3D-Integration geeignet sind, finden Sie auf Flip-Chip Bonder von SET, wie:
- In-Situ aufschmelzen (in Situ Reflow)
- Thermokompression
- Adhäsives Bonden
- Direktes metallisches Bonden
- Usw.…
